晶圆减薄抛光一体机:无他,唯有高端替代高端 | 北拓研究
2023-10-2618:00
当我们在讨论国产替代时,我们要注意区分,这个产品是国产没有,还是国内有,只是稳定性或者性能不够。但更重要的是,我们要注意这个产品是国内平替勉强能用,还是只能高端替代高端。今天要介绍的是半导体赛道里技术壁垒相当高的“晶圆减薄抛光一体机”,它没有平替选择,只有能用和不能用,是 0 和 1 的区别。未来,晶圆薄化是大趋势,晶圆减薄抛光一体机是投资者应当重点关注的赛道。
1、减薄和抛光
减薄(Thinning)是一种半导体制造工艺,指削薄晶圆以满足封装工艺的要求。实现这一工艺的关键设备是晶圆减薄机。国内减薄机发展迅速,但仍需在技术、性能、加工精度和市场份额等方面迎头赶上行业巨头。未来,本土企业为了迎合市场需要持续加大研发力度,提高国产化率。随着芯片线宽的不断缩小、芯片结构的三维化以及先进封装技术的演进,化学机械抛光(Chemical Mechanical Polishing,CMP)设备和减薄设备将获得更广泛的应用,为国内相关设备公司提供了长期高速发展的机遇。这些发展对半导体行业和电子设备制造业具有重要意义。晶圆减薄工艺的作用是对已完成功能的晶圆(主要是硅晶片)的背面基体材料进行磨削,去掉一定厚度的材料。有利于后续封装工艺的要求以及芯片的物理强度,散热性和尺寸要求。更薄的芯片可以通过衬底散热来提升散热效果,减薄的芯片可以实现紧凑型或微电子设备中的堆叠和高密度封装,减薄的芯片可以减少内部应力,而更薄的晶圆还可以提升芯片的器件性能并提高后续划片加工的成品率。2 、抛光
CMP 工作原理是在一定压力下及抛光液的存在下,被抛光的晶圆对抛光垫做相对运动,借助纳米磨料的机械研磨作用与各类化学试剂的化学作用之间的高度有机结合,使被抛光的晶圆表面达到高度平坦化、低表面粗糙度和低缺陷的要求。根据不同工艺制程和技术节点的要求,每一片晶圆在生产过程中都会经历几道甚至几十道的 CMP 抛光工艺步骤。与传统的纯机械或纯化学的抛光方法不同,CMP 工艺是通过表面化学作用和机械研磨的技术结合来实现晶圆表面微米 / 纳米级不同材料的去除,从而达到晶圆表面的高度(纳米级)平坦化效应,使下一步的光刻工艺得以顺利进行。化学作用是指抛光液中的化学品和硅片表面发生化学反应,生成比较容易去除的物质,物理过程是指抛光液中的磨粒和硅片表面材料发生机械物理摩擦,去除化学反应生成的物质。
1、总的来看
随着全球信息化发展以及智能化的普及。由人工智能,新能源汽车等新行产业的牵引,全球半导体产业规模上行,从 2020 年 4,404 亿美元上涨到 2022 年 5,735 亿美元。晶圆厂扩张带动的减薄抛光市场增加。根据 SEMI 的数据,2021 年全球半导体设备销售额达到 1,026 亿美元。半导体晶圆制造涉及众多设备,包括刻蚀、薄膜沉积、光刻、量测、清洗、CMP、离子注入和热处理等。其中,CMP 设备市场规模约占整个 IC 制造设备市场规模的 3% 左右。SEMI 预测,2022 年全球前道半导体设备销售额将达到 1,070 亿美元,同比增长 18%。近年来,中国晶圆厂扩产的推动使中国半导体设备销售额在全球市场上持续增加。根据 SEMI 的数据,在 2022 年全球前道半导体设备销售额预计达到 1,070 亿美元的情况下,假设前道设备销售占半导体设备销售总额的 86%,并且中国在 2022 年的全球占比提升至 31% 的情况下,预计中国半导体设备销售额将接近 386 亿美元,同比增长 30%。
2、核心驱动因素:先进封装平台正在推动对减薄工艺的更多需求
- 先进封装比例提升,减薄抛光一体化设备拥有广阔空间。未来,全球半导体封装测试市场将在传统工艺保持较大比重的同时,继续向着小型化、集成化、低功耗方向发展,附加值更高的先进封装将得到越来越多的应用。据 Yole Developpement 预测,全球先进封装占比将在 2025 年达到 50% 左右,同时我国先进封装产值占全球比例也从 2015 年的 10.3% 提升至 2020 年 14.8%,国内封装测试业市场有望持续向好。潜在客户除现有 IDM 模式客户外,将进一步向封测企业延伸,在先进封装技术快速发展、国内封测市场不断增加、国产化率迅速提升背景下,减抛光一体化设备拥有广阔市场空间。
- 3D 封装发展成为必然趋势:随着芯片越来越复杂,芯片面积、良率和复杂工艺的矛盾难以调和,3D 封装是发展的必然趋势。与传统封装相比,3D 封装技术有望提供更高的芯片连接性和更低的功耗,而对于如何提升芯片接点互连密度,以及将各种不同的小芯片 (Chiplet) 进行极致的异构集成,则将会是先进封装领域的核心技术优势。与 2.5D 不同的是,3D 通常含有芯片或器件之间的堆叠。在高性能计算芯片中,通过 3D 堆叠技术可以扩大内存芯片的容量、提升传输带宽,同时由于堆叠中引线的减少,大大降低了消芯片中因数据传输造成的不必要的能量损耗,因此采用 TSV 工艺的 3D IC 大量运用于存储器(SRAM、DRAM、Flash)、GPU、CPU 中。
3D 封装依靠倒装封装(FC)、TSV 技术等互连方法实现异构集成(Heterogenous Integration)。3D 封装包括使用重新分配层(RDL)和凸点工艺形成互连的晶圆级封装(WLP),以及小芯片技术——将封装单个芯片进行堆叠,并采用引线键合、倒装芯片(FC)或二者混合的组装工艺,或硅通孔技术(TSV)进行互连,组装成一颗大芯片,从而实现大芯片的功能和性能,而这种小面积的芯片就是 Chiplet(小芯片 / 芯粒),芯粒的优势在于其面积较小,可以提高良率,实现异构集成,具有成本优势。所谓异构集成(Heterogenous Integration),广义来说就是将两种以上不同功能的芯片,例如内存与逻辑芯片、光电及电子组件、或传感器与读取电路等,通过 2.5D/3D 芯片堆栈的封装工艺整合在一起。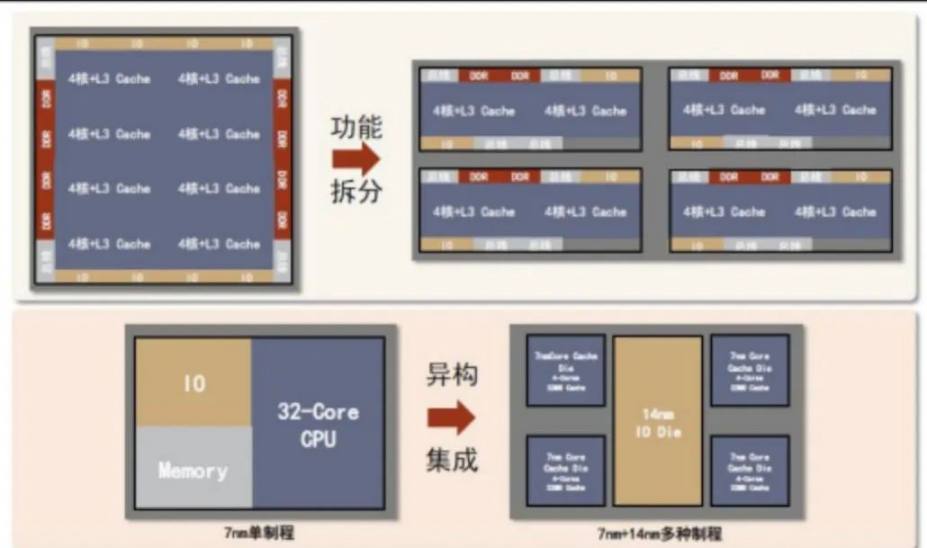
随着芯片越来越复杂,芯片面积、良率和复杂工艺的矛盾难以调和,3D 封装是发展的必然趋势。与传统封装相比,3D 封装技术有望提供更高的芯片连接性和更低的功耗,而对于如何提升芯片接点互连密度,以及将各种不同的小芯片 (Chiplet) 进行极致的异构集成,则将会是先进封装领域的核心技术优势。与 2.5D 不同的是,3D 通常含有芯片或器件之间的堆叠。在高性能计算芯片中,通过 3D 堆叠技术可以扩大内存芯片的容量、提升传输带宽,同时由于堆叠中引线的减少,大大降低了消芯片中因数据传输造成的不必要的能量损耗,因此采用 TSV 工艺的 3D IC 大量运用于存储器(SRAM、DRAM、Flash)、GPU、CPU 中。
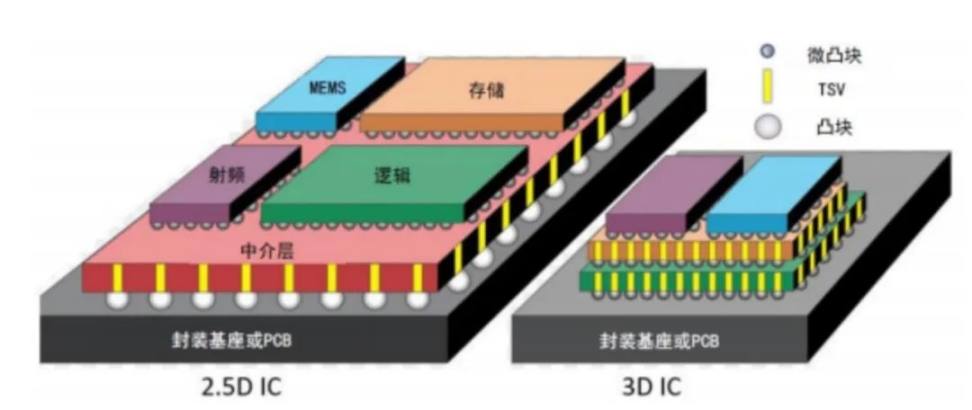
减薄抛光一体机主要面向 3D 先进封装市场。为实现多层晶圆堆叠、降低互联延迟与芯片体积、提升芯片集成度与散热特性,3D 先进封装技术需将晶圆背面基底材料进行减薄,并保证极好的平整度与表面质量,因此晶圆减薄是 3D 先进封装关键技术之一,减薄工艺要将晶圆厚度从 775 微米降至 10 微米以内,现有 3D 工艺通常需要先通过减薄设备实现背面减薄,再利用 CMP 设备。
晶圆减薄技术是实现半导体设备小型化的重要关键技术。后端晶圆减薄工艺主要包括两种设备。晶圆贴合设备(BG 胶带贴合和移除、切割胶带贴合)和晶圆背面研磨设备(包括粗 / 细研磨、抛光、清洗和干燥、蚀刻、平面化、CMP、临时粘接 / 脱胶和边缘增强)。
① 不同产品对晶圆厚度减薄要求存在差异,厚度大幅降低显著增加对减薄设备的品质需求② 晶圆厚度一般约为 750μm,可将晶圆减薄至 100um 左右(最厚的晶圆用于逻辑门,厚度为 100µm),以确保机械稳定性并防止高温加工过程中的翘曲。③ 随着 3D 封装应用逐渐增多,要求晶圆厚度减薄至 50-100um 甚至 50um 以下,将显著增加对减薄设备的品质需求。④ DRAM 内存通常需要厚度为 50um 的晶圆。① 对晶圆背面研磨工艺的描述是高水平的,但整个制造工艺受到非常严格的控制。② 衡量减薄机最粗暴的技术指标晶圆厚度精度,片内(TTV)厚度和片间(WTW)厚度。③ 晶圆表面粗糙度要求、晶圆表面损伤层厚度(SSD)要求、晶圆厚度一致性要求;④ 技术位阶:目前全球最顶级的研磨设备为东京精密 HRG3000RMX,精度为 TTV/WTW 0.5μm,独占鳌头;国内最高精度为华海清科 Versatile-GP300TTV<1μm,中电科 WG1261 WTW≤2μm,步步紧逼。晶圆减薄方法包括机械研磨、化学机械平坦化 (CMP)、湿法蚀刻以及大气下游等离子体 (ADP) 和干法化学蚀刻 (DCE)。然鹅,两种最常见的晶圆减薄方法是传统研磨 / 磨削和化学机械平坦化。磨削是目前晶圆背面减薄的最传统的机械工艺,其基本原理是通过旋转的金刚砂轮对晶圆背面进行磨削,金刚砂轮基材通常有陶瓷、环氧树脂。研磨配方决定了主轴的速度,也决定了材料去除率,所有这些都决定了晶圆的最终预期厚度。概括来说,机械研磨过程包括 2 个步骤:粗磨:这是去除大部分材料的地方,去除率约为 5μm/ 秒;精磨:采用 1200 至 2000 目砂和 poligrind 精磨,通常每秒可去除约 30μm 堆积的材料(从 1μm 或更小)。这里是晶圆最终完成的地方。 图源:integra-tech化学机械平坦化 (CMP) 方法也称为化学机械抛光,是使用研磨化学浆料和抛光垫进行材料去除。它可以压平晶圆并平整表面上的不规则形貌,从而提供比机械研磨更好的平坦化效果,但它通常更昂贵且不太干净。化学机械平坦化按以下步骤进行:③ 每次抛光时,抛光垫旋转 60-90 秒,具体取决于所需厚度的规格。CMP 的减薄速度比机械研磨慢,因为它每秒仅去除几微米。这使晶圆具有近乎完美的平整度和非常可控的总厚度变化 (TTV)。CMP 可实现对晶圆背面近乎完美的超精密抛光。
图源:integra-tech化学机械平坦化 (CMP) 方法也称为化学机械抛光,是使用研磨化学浆料和抛光垫进行材料去除。它可以压平晶圆并平整表面上的不规则形貌,从而提供比机械研磨更好的平坦化效果,但它通常更昂贵且不太干净。化学机械平坦化按以下步骤进行:③ 每次抛光时,抛光垫旋转 60-90 秒,具体取决于所需厚度的规格。CMP 的减薄速度比机械研磨慢,因为它每秒仅去除几微米。这使晶圆具有近乎完美的平整度和非常可控的总厚度变化 (TTV)。CMP 可实现对晶圆背面近乎完美的超精密抛光。 全局平坦化实景 图源:Logitech
全局平坦化实景 图源:Logitech
1、国外玩家
a.东京精密
东京精密简称 TSK,创立于 1949 年,是全球半导体行业享有盛誉的日本企业,硅片背面抛光机是其核心业务之一。减薄研磨机源自 ACCRETECH 独特的设想,可实现各种 IC 卡、SiP、三维封装技术中要求的薄片化、去除损伤的一体化设备。减薄研磨机代表型号有 PG3000 RMX 是实现 15um 厚度晶圆量产的高度集成化一体机。
Accretech 的 PG 系列可以抛光超薄晶圆,和 RM 系统的连接,可以在下料时给晶圆背面自动贴上切割胶带。同时,可以选配 NCIG 非接触式在线测量和自动 TTV 控制、NCIG 非接触式在线测量和自动 TTV 控制、WCS ( 晶圆清洗系统 ) 和激光切割机的集成系统。针对碳化硅,东京精密推出了高精度和高刚性的研磨机 HRG3000RMX(TTV 0.5μm,WTW,±0.5μm),全自动高刚性三轴研磨机具备可实现快速无损伤的镜面加工。另外一款全自动高刚性双轴研磨机 HRG200X,具备高精度(TTV 1μm,WTW±1μm)可实现在短时间之内的无损加工。其他型号还有 HRG3000XF、PG3000RMX series,CMP 设备是 ChaMP 211。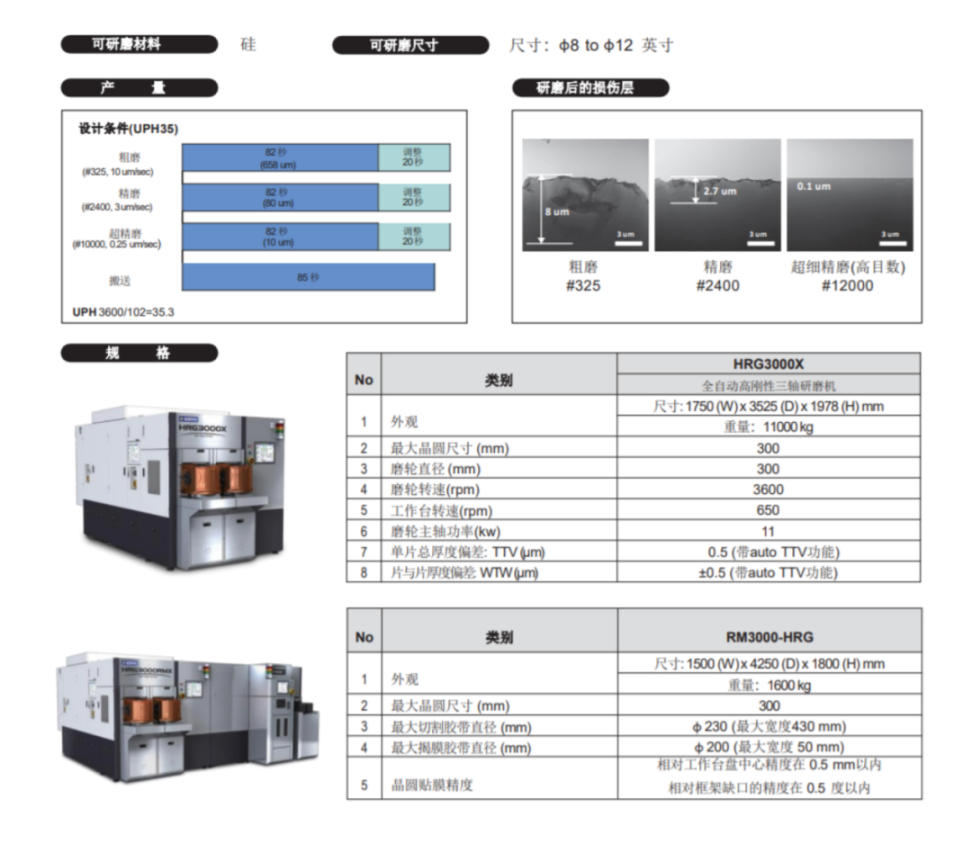
B.DISCO
全球半导体设备材料巨头日本 DISCO 成立于 1937 年,多年来专注于“Kiru ( 切 )、Kezuru ( 磨 )、Migaku ( 抛 )”领域,形成了半导体切、磨、抛装备材料完善的产品布局,贯穿半导体全制程的重要工艺流程,凭借产品在精度、性能和稳定性上的优势,其减薄研磨机及其耗材造成了寡头垄断。DISCO 的减薄设备精准度非常高,可以将晶圆的背面研磨至 5µm 厚度,约为日常复印机纸张厚度的 1/20,加工过后材料即呈现半透明状,公司设备亦可将直径为 30 cm 的晶圆的厚度变化控制在 1.5 µm 以内,这大大提高了材料的抗断裂性。减薄设备:包含研磨机(Grinders)、抛光机(Polishers)、研磨抛光一体机(Grinder/Polisher)、表面平坦机(Surface Planer)、晶圆贴膜机(Tape Mounter)。研磨机型有 DFG8340、DFG8540/41、DFG8560、DFG8640、DFG8830、DGP8761;抛光机型有 DFP8140、DFP8141、DFP8160、DAG810。 (图为 DGP8760)
(图为 DGP8760)
C.德国 G&N(纽伦堡精密机械设备公司)
德国 G&N(纽伦堡精密机械设备公司)是一家精密平面研磨机制造商,前身为 1940 年成立的德国 Kugelmüller 有限公司,并于 1964 年开发了世界第一台半导体晶圆研磨机。减薄研磨机有型号 MPS2 R300 CV、MPS R400 CV、MPS R400 CV TWIN、MPS RC Vacuum 。可实现 TTV≤3um,片差厚度≤2μm。主要用于对半导体晶圆进行减薄与精密研磨,该系统采用一个主轴,可安装粗磨砂轮和精磨砂轮,系统稳定性好,研磨精度高,适合科研客户及小批量生产客户。 MPS R400CV 晶圆研磨机 / 减薄机
MPS R400CV 晶圆研磨机 / 减薄机D.Okamoto Semiconductor Equipment Division
自 1935 年以来,Okamoto Semiconductor Equipment Division 一直是精密研磨和抛光工具的领先制造商。对于薄晶片应用,研磨 / 抛光系统可以与贴片机、DAF 和去贴设备集成为一个完整的在线系统。代表型号有 VG-101MKII 全自动晶圆研磨机和双抛光在线系统,用于生产中的晶圆减薄 25um 能力。可选集成磨边机,非接触式激光厚度检测可选。可直接连接到拆堆机 / 贴装机。
2、国内玩家
A. 华海清科【已开发减薄抛光一体机】
2020 年起,华海清科独立承担减薄相关的国家级重大专项课题,通过超精密减薄技术开发进一步将晶圆减薄与化学机械抛光(CMP)合理结合,开展包括超精密研磨面形控制技术、超精密多工位减薄整机技术和减薄智能工艺控制技术在内的超精密减薄技术研发,成功研发出拥有自主知识产权的 12 英寸减薄抛光一体机 Versatile-GP300,此类设备主要适用于先进集成电路制造的晶圆背面减薄工艺,以满足 3D IC 对超精密磨削、CMP 及清洗的一体化工艺需求,截止 2022 年 6 月,其 Versatile-GP 300 产品已通过大生产线考核验证,可以应用于 3D IC 制造、先进封装等芯片制造生产线,预计在 2023 年实现量产并贡献收入。
公司基于自身对 CMP 设备技术积累,2023 年 5 月开发出 Versatile-GP300 减薄抛光一体机(晶圆超精密磨削、CMP、清洗集成设备),配置先进的厚度偏差与表面缺陷控制技术,提供多种系统功能扩展选项,具有高精度(稳定实现 12 英寸晶圆片内磨削 TTV<1um)、高刚性、工艺开发灵活等优点,实现了减薄工艺全过程的稳定可控。达到了国内领先和国际先进水平。主要适用于前道晶圆制造、先进封装的晶圆减薄需求。目前已批量进入大生产线。
Versatile-GM300 是面向封装领域创新研发的超精密晶圆减薄设备。该设备采用新型布局,可实现薄型晶圆背面超精密磨削与应力去除;兼容 8/12 英寸晶圆,依托卓越的厚度在线测量与表面缺陷控制技术,具有高精度、高刚性、工艺开发灵活等优点,满足封装领域的薄型晶圆加工需求。
华海清科调研(20220808):Q1:减薄抛光一体机的应用场景是怎样的?A:一般在硅片制造、3D IC 制造以及先进封装领域会用到减薄机,且随着芯片制造技术愈发先进,减薄机的应用变得更加广泛,例如在 3D IC 制造过程中晶圆的键合工艺就需要对其晶圆背部进行打薄,属于必要的工序。
Q2:请问公司减薄抛光一体机的进展是怎样的?A:公司减薄抛光一体机已按照公司所承担的国家级重大专项课题任务书约定交付指定客户,现在处于验证阶段,验证进展比较好。
B.中电科子公司(北京中电科电子装备有限公司)【已开发减薄抛光一体机】
承接国家 02 专项“300mm 超薄晶圆减薄抛光一体机研发与产业化“项目在 2020 年 4 月通过科技部正式验收,标志着国内在集成电路高端装备自主创新进程上实现新的突破。中科电减薄一体机是国内首台拥有自主知识产权并满足大生产的 300mm 减薄抛光一体机,具备晶圆粗磨、精磨、非接触测量、抛光、清洗、传输和保护膜处理等全自动流片能力。目前已出货的型号有 WG-8501、WG-1251、WG-8500、WG-1220、WG-6110、WG-1250。
2023 年 6 月 6 日北京中电科电子装备有限公司碳化硅全自动减薄机 WG1261 顺利交付并批量市场销售。该设备是碳化硅全自动减薄机最新研发成果的集中体现,与它的前任(WG1251)相比,片内厚度偏差和片厚度偏差精进至 2μm,指标和性能达到全球一流水准。最终可以实现碳化硅晶圆 100 微米以下的超精密磨削,领先国内水平,与国际水平相当。该机器汇集了北京中电科自主研发的核心零部件气浮主轴与气浮载台、超低速亚微米级运动控制技术,晶圆厚度分区域自动控制等多项最新研发关键技术,不仅加工一致性好、面型精度控制能力强、效率高、损伤层小,而且易于实现自动化。下一步,北京中电科将聚焦汽车芯片等领域,全力提升碳化硅减薄机产能。
C. 京创先进
京创先进致力于提供先进的自主化、系列化、智能化半导体国产装备及配套工艺一体化解决方案,减薄、抛光是其最重要的产品线之一。2023 年 4 月,京创先进推出新品 AG6800 全自动减薄机和 AG7500 自动减薄机。实现单片晶圆内的厚度差 1.5μm 以下,不同晶圆间的厚度差±3μm 以下。
AG6800 采用了双主轴,三工作盘,加工效率更高。配备全自动上下料、传输定位、清洗干燥,实现全自动运行模式,大大降低 OP 工作量。主要用于 3-8 英寸半导体晶圆的全自动减薄加工。AG7500 结构简单紧凑,空间占比小。通过采用高刚性,低振动的主轴,实现了更好的研削加工品质。可有效于硬质和脆性材料以及电子元件产品的研削加工。主要用于 12 英寸半导体晶圆的全自动减薄加工。
D.特思迪
专注于半导体领域超精密平面加工设备的研发、生产和销售企业,有全自动 CMP 抛光机 TPC-2110、全自动减薄机 TFG-3200、单面抛光机 TSP-1270、双面抛光机 TDP-1200。其 TFG-3200 可磨削各类半导体材料兼容 6&8 英寸晶圆减薄。E.晶盛机电
- 国内领先的半导体材料装备企业。2022 年 12 月,晶盛机电首台半导体 12 英寸双轴减薄机成功下线,标志着晶盛机电正式进军封装市场。公司宣称已得到国内知名 FAB 厂的技术确认。
F.上海技美科技股份有限公司
【2020 年】减薄抛光一体机国家专项通过整体验收进入产业化。【2021 年】TAIKO 晶圆激光切环贴膜机、晶圆分切贴膜机等行业首台套开发。“****”工艺正式提出。【2022 年】12”高性能晶圆减薄抛光机研发。上海新工厂启用。
【免责声明】市场有风险,投资需谨慎。本文不构成投资建议,用户应考虑本文中的任何意见、观点或结论是否符合其特定状况。据此投资,责任自负。




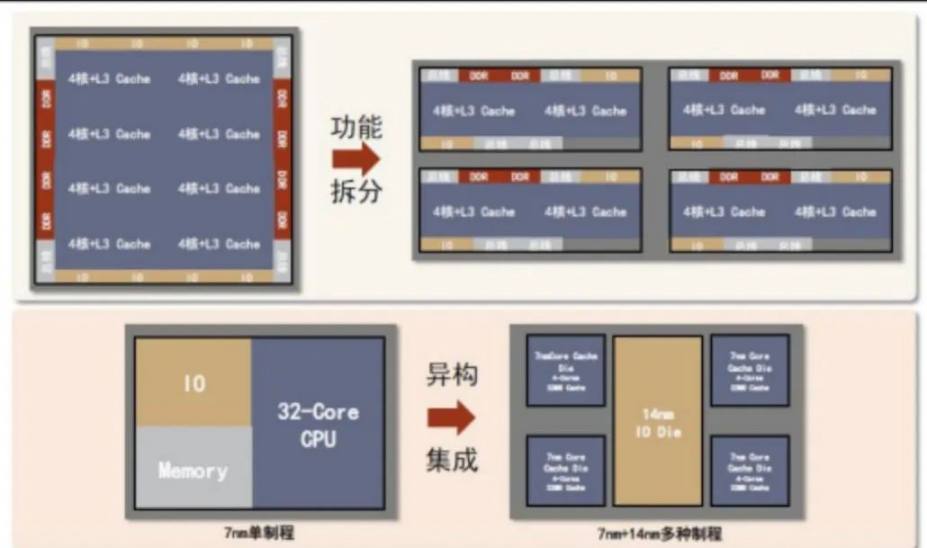
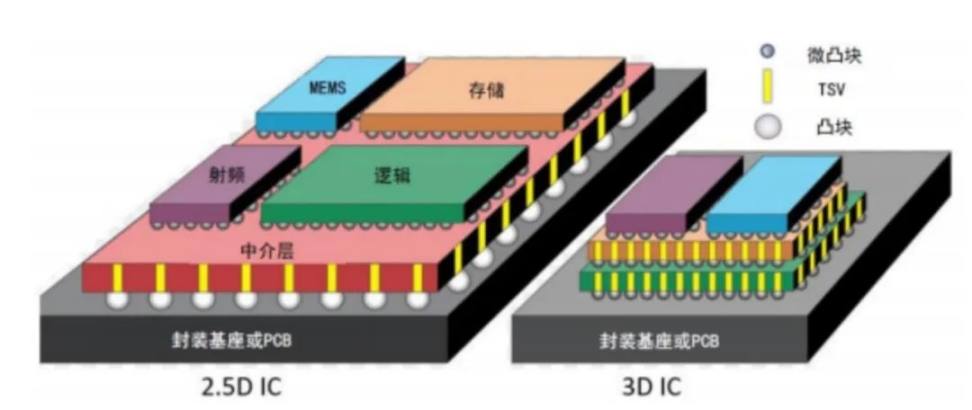

 图源:integra-tech
图源:integra-tech 全局平坦化实景 图源:Logitech
全局平坦化实景 图源:Logitech
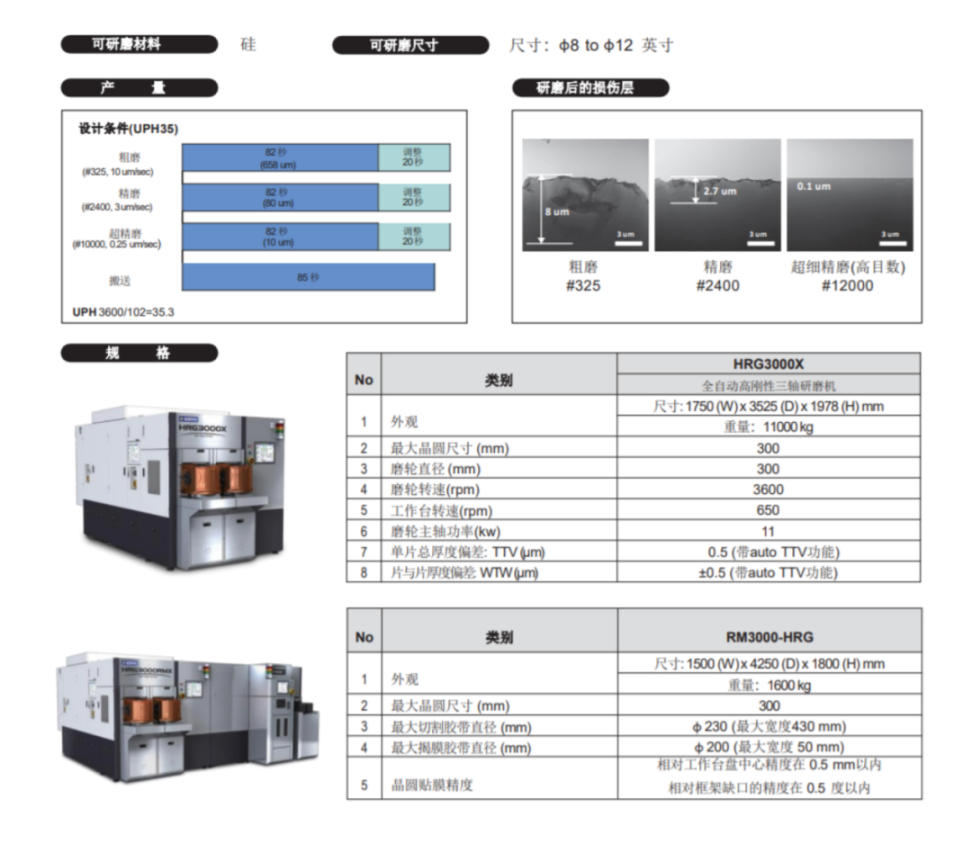
 (图为 DGP8760)
(图为 DGP8760) MPS R400CV 晶圆研磨机 / 减薄机
MPS R400CV 晶圆研磨机 / 减薄机





